激光全切割切割工藝
該過程包括將激光饋送到減薄晶片(小于 200 μm)的正面(圖案側)一次,或多次照射晶片直至切割膠帶。激光全切割可以提高產量,因為可以提高進給速度。
GaAs(砷化鎵)等化合物半導體用于高頻器件。使用現有的金剛石刀片對化合物半導體進行刀片切割時,進給速度慢,難以獲得高生產率。
隨著高度集成化的趨勢,基于SiP(System in Package)等技術的高強度薄芯片制造技術已成為必要。然而,使用刀片切割,隨著晶片厚度變薄,切割難度增加。
針對此類問題,DISCO對DFL7161激光鋸的激光頭和光學系統進行了優化,建立了激光全切割應用。
該過程包括將激光饋送到減薄晶片(小于 200 μm)的正面(圖案側)一次,或多次照射晶片直至切割膠帶。激光全切割可以提高產量,因為可以提高進給速度。
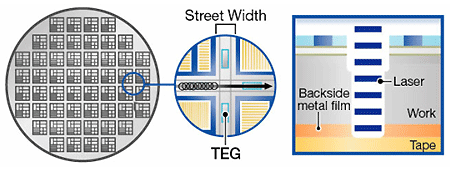
GaAs 化合物半導體的薄晶片切割
在切割過程中,由于材料非常脆,GaAs 晶片很容易發生破損和開裂。因此,難以使用現有的刀片切割來提高進給速度。使用激光全切割切割,可以以比刀片切割快十倍的進給速度進行加工,從而提高產量。(這只是一個例子。實際速度取決于要處理的晶圓。)
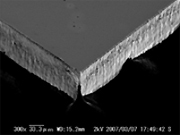
GaAs 晶圓 SEM 圖像
* 在處理 GaAs 時,需要額外的設備來去除汽化的 As 氣體。
減薄硅片全切劃片
隨著晶圓變得更薄,切割過程中的碎裂和開裂對芯片強度的影響更大。因此,切割難度正在增加,因為需要更好地控制碎裂的工藝。此外,使用芯片貼膜 (DAF) 作為接合材料以堆疊減薄芯片的設備數量正在增加。因此,在控制毛刺的發生的同時,對背面附有 DAF 的晶片進行高質量切割已成為一個問題。
其他激光全切加工實例
背面金屬膜貼附硅片、GaP(磷化鎵)片、InP(磷化銦)片、GaN(氮化鎵)片和Ge(鍺)片。
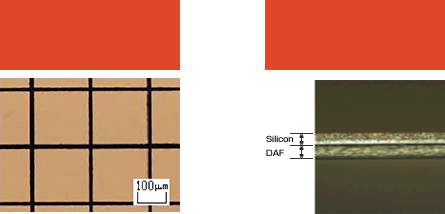
與我們產生合作,還原您產品藍圖里應有的樣子!
立即聯系我們