激光開槽工藝
先在切割道內切開2條細槽(開槽),然后再使用磨輪刀片在2條細槽的中間區域實施全切割加工。通過采用該項加工工藝,能夠提高生產效率,減少甚至解決因崩裂、分層(薄膜剝離)等不良因素造成的加工質量問題。
應用于高速邏輯元器件絕緣膜的Low-k膜,因其機械強度低,若使用普通的刀片進行切割加工,會發生Low-k膜剝落的風險。這種通過激光去除Low-k膜以及相應配線層的加工,就是激光開槽工藝。
先在切割道內切開2條細槽(開槽),然后再使用磨輪刀片在2條細槽的中間區域實施全切割加工。通過采用該項加工工藝,能夠提高生產效率,減少甚至解決因崩裂、分層(薄膜剝離)等不良因素造成的加工質量問題。
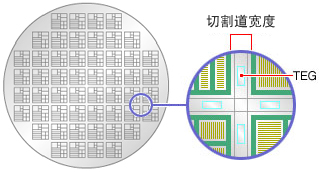
GaAs 化合物a半導體的薄晶片切割
在切割過程中,由于材料非常脆,GaAs 晶片很容易發生破損和開裂。因此,難以使用現有的刀片切割來提高進給速度。使用激光全切割切割,可以以比刀片切割快十倍的進給速度進行加工,從而提高產量。(這只是一個例子。實際速度取決于要處理的晶圓。)
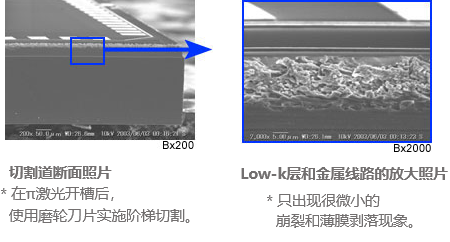
追求加工精度和操作便利性
由于在適用于300 mm晶片的全自動激光切割機DEL7161上采用了非發熱加工方式即短脈沖激光切割技術,來去除切割道上的Low-k膜及銅等金屬布線,所以能夠在開槽加工過程中最大限度地排除因發熱所產生的影響。另外,在該設備上還配置了LCD觸摸屏和圖形化用戶界面(GUI),使操作更為方便。
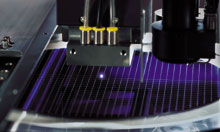
切割道斷面照片
* 在π激光開槽后,使用磨輪刀片實施階梯切割。
切割加工質量
將短脈沖激光聚焦到晶片表面后進行照射。激光脈沖被Low-k膜連續吸收,當吸收到一定程度的熱能后,Low-k膜會瞬間汽化。由于相互作用的原理,被汽化的物質會消耗掉晶片的熱能,所以可以進行熱影響極少的加工。
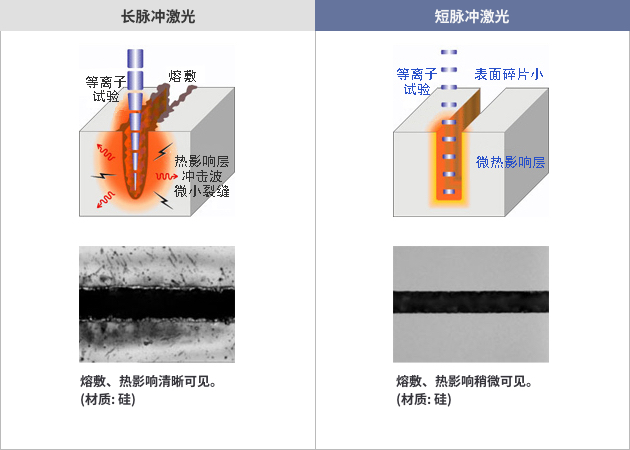
與我們產生合作,還原您產品藍圖里應有的樣子!
立即聯系我們